PCT測試目的與應用
PCT測試目的與應用
說明:PCT試驗一般稱為壓力鍋蒸煮試驗或是飽和蒸汽試驗,最主要是將待測品置於嚴苛之溫度、飽和濕度(100%R.H.)[飽和水蒸氣]及壓力環境下測試,測試代測品耐高濕能力,針對印刷線路板(PCB&FPC),用來進行材料吸濕率試驗、高壓蒸煮試驗..等試驗目的,如果待測品是半導體的話,則用來測試半導體封裝之抗濕氣能力,待測品被放置嚴苛的溫濕度以及壓力環境下測試,如果半導體封裝的不好,濕氣會沿者膠體或膠體與導線架之介面滲入封裝體之中,常見的故裝原因:爆米花效應、動金屬化區域腐蝕造成之斷路、封裝體引腳間因污染造成之短路..等相關問題。
壓力蒸煮鍋試驗(PCT)結構:試驗箱由一個壓力容器組成,壓力容器包括一個能産生100%(潤濕)環境的水加熱器,待測品經過PCT試驗所出現的不同失效可能是大量水氣凝結滲透所造成的。
澡盆曲線:澡盆曲線(Bathtub curve、失效時期),又用稱為浴缸曲線、微笑曲線,主要是顯示產品的於不同時期的失效率,主要包含早夭期(早期失效期)、正常期(隨機失效期)、損耗期(退化失效期),以環境試驗的可靠度試驗箱來說得話,可以分爲篩選試驗、加速壽命試驗(耐久性試驗)及失效率試驗等。進行可靠性試驗時"試驗設計"、"試驗執行"及"試驗分析"應作爲一個整體來綜合考慮。

常見失效時期:
早期失效期(早夭期,Infant Mortality Region):不夠完善的生産、存在缺陷的材料、不合適的環境、不夠完善的設計。
隨機失效期(正常期,Useful Life Region):外部震蕩、誤用、環境條件的變化波動、不良抗壓性能。
退化失效期(損耗期,Wearout Region):氧化、疲勞老化、性能退化、腐蝕。
環境應力與失效關係圖說明:
依據美國Hughes航空公司的統計報告顯示,環境應力造成電子產品故障的比例來說,高度佔2%、鹽霧佔4%、沙塵佔6%、振動佔28%、而溫濕度去佔了高達60%,所以電子產品對於溫濕度的影響特別顯著,但由於傳統高溫高濕試驗(如:40℃/90%R.H.、85℃/85%R.H.、60℃/95%R.H.)所需的時間較長,為了加速材料的吸濕速率以及縮短試驗時間,可使用加速試驗設備(HAST[高度加速壽命試驗機]、PCT[壓力鍋])來進行相關試驗,也就所謂的(退化失效期、損耗期)試驗。

θ 10℃法則:討論産品壽命時,一般採用[θ10℃法則]的表達方式,簡單的說明可以表達爲[10℃規則],當周圍環境溫度上升10℃時,産品壽命就會減少一半;當周圍環境溫度上升20℃時,産品壽命就會減少到四分之一。
這種規則可以說明溫度是如何影響産品壽命(失效)的,相反的產品的可靠度試驗時,也可以利用升高環境溫度來加速失效現象發生,進行各種加速壽命老化試驗。
濕氣所引起的故障原因:水汽滲入、聚合物材料解聚、聚合物結合能力下降、腐蝕、空洞、線焊點脫開、引線間漏電、晶片與晶片粘片層脫開、焊盤腐蝕、金屬化或引線間短路。
水汽對電子封裝可靠性的影響:腐蝕失效、分層和開裂、改變塑封材料的性質。
PCT對PCB的故障模式:起泡(Blister)、斷裂(Crack)、止焊漆剝離(SR de-lamination)。
半導體的PCT測試:PCT最主要是測試半導體封裝之抗濕氣能力,待測品被放置嚴苛的溫濕度以及壓力環境下測試,如果半導體封裝的不好,濕氣會沿者膠體或膠體與導線架之介面滲入封裝體之中,常見的故裝原因:爆米花效應、動金屬化區域腐蝕造成之斷路、封裝體引腳間因污染造成之短路..等相關問題。
PCT對IC半導體的可靠度評估項目:DA Epoxy、導線架材料、封膠樹脂
腐蝕失效與IC:腐蝕失效(水汽、偏壓、雜質離子)會造成IC的鋁線發生電化學腐蝕,而導致鋁線開路以及遷移生長。
塑封半導體因濕氣腐蝕而引起的失效現象:
由於鋁和鋁合金價格便宜,加工工藝簡單,因此通常被使用爲積體電路的金屬線。從進行積體電路塑封製程開始,水氣便會通過環氧樹脂滲入引起鋁金屬導線産生腐蝕進而産生開路現象,成爲品質管理最爲頭痛的問題。雖然通過各種改善包括採用不同環氧樹脂材料、改進塑封技術和提高非活性塑封膜爲提高産品質量進行了各種努力,但是隨著日新月異的半導體電子器件小型化發展,塑封鋁金屬導線腐蝕問題至今仍然是電子行業非常重要的技術課題。
鋁線中産生腐蝕過程:
① 水氣滲透入塑封殼內→濕氣滲透到樹脂和導線間隙之中
② 水氣滲透到晶片表面引起鋁化學反應
加速鋁腐蝕的因素:
①樹脂材料與晶片框架介面之間連接不夠好(由於各種材料之間存在膨脹率的差異)
②封裝時,封裝材料摻有雜質或者雜質離子的污染(由於雜質離子的出現)
③非活性塑封膜中所使用的高濃度磷
④非活性塑封膜中存在的缺陷
爆米花效應(Popcorn Effect):
說明:原指以塑膠外體所封裝的IC,因其晶片安裝所用的銀膏會吸水,一旦末加防範而逕行封牢塑體後,在下游組裝焊接遭遇高溫時,其水分將因汽化壓力而造成封體的爆裂,同時還會發出有如爆米花般的聲響,故而得名,當吸收水汽含量高於0.17%時,[爆米花]現象就會發生。近來十分盛行P-BGA的封裝元件,不但其中銀膠會吸水,且連載板之基材也會吸水,管理不良時也常出現爆米花現象。
水汽進入IC封裝的途徑:
1.IC晶片和引線框架及SMT時用的銀漿所吸收的水
2.塑封料中吸收的水分
3.塑封工作間濕度較高時對器件可能造成影響;
4.包封後的器件,水汽透過塑封料以及通過塑封料和引線框架之間隙滲透進去,因為塑膠與引線框架之間只有機械性的結合,所以在引線框架與塑膠之間難免出現小的空隙。
備註:只要封膠之間空隙大於3.4*10^-10m以上,水分子就可穿越封膠的防護
備註:氣密封裝對於水汽不敏感,一般不採用加速溫濕度試驗來評價其可靠性,而是測定其氣密性、內部水汽含量等。
爆米花效應示意圖:
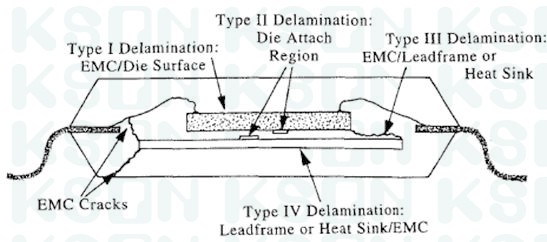
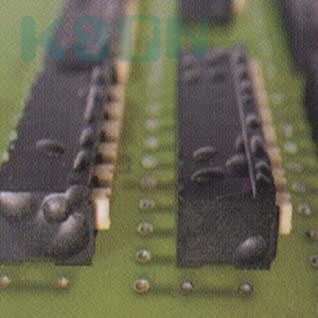
針對JESD22-A102的PCT試驗說明:
用來評價非氣密封裝器件在水汽凝結或飽和水汽環境下抵禦水汽的完整性。
樣品在高壓下處於凝結的、高濕度環境中,以使水汽進入封裝體內,暴露出封裝中的弱點,如分層和金屬化層的腐蝕。該試驗用來評價新的封裝結構或封裝體中材料、設計的更新。
應該注意,在該試驗中會出現一些與實際應用情況不符的內部或外部失效機制。由於吸收的水汽會降低大多數聚合物材料的玻璃化轉變溫度,當溫度高於玻璃化轉變溫度時,可能會出現非真實的失效模式。
外引腳錫短路:封裝體外引腳因濕氣引起之電離效應,會造成離子遷移不正常生長,而導致引腳之間發生短路現象。

(離子遷移)
濕氣造成封裝體內部腐蝕:濕氣經過封裝過程所造成的裂傷,將外部的離子污染帶到晶片表面,在經過經過表面的缺陷如:護層針孔、裂傷、被覆不良處..等,進入半導體原件裡面,造成腐蝕以及漏電流..等問題,如果有施加偏壓的話故障更容易發生。
PCT試驗條件(整理PCB、PCT、IC半導體以及相關材料有關於PCT[蒸汽鍋測試]的相關測試條件)

